LG to Introduce Advanced Chip Packaging Method
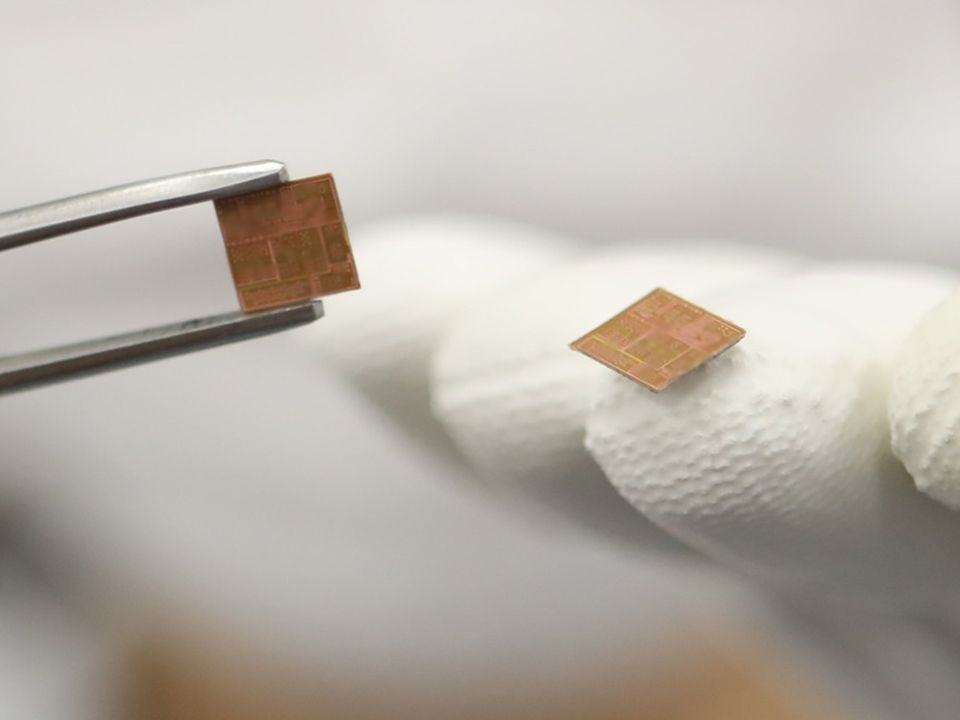
Image Credits: LG Develops
LG Electronics, a leading multinational electronics company, has announced the development of a next-generation chip packaging method to boost the power efficiency of high bandwidth memory (HBM) chips, marking a strategic move into a new business.
Companies like SK Hynix and Samsung Electronics plan to adopt techniques like dubbed hybrid bonding, which allows higher chip stacking and higher capacity by using copper-to-copper bonding.
A spokesperson from LG said, “LG's Production-engineering Research Institute is researching and developing the technology as a part of its endeavour to develop new chip packaging and testing methods.”
Seoul Economic Daily confirmed the news that the Korean electronics manufacturer will enter the hybrid bonding business to mass-produce the new product in 2028. “We are reviewing the business without a buyer decided”, they reported while declining to confirm the reported target year.
The packaging technique is yet to be commercialized by local suppliers like Hanmi Semiconductor, Hanwha Semitech, and a subsidiary of Samsung, Semes.
The two leading manufacturing companies of HBM, Samsung Electronics and SK Hynix, have been reliant on conventional packaging techniques, TC bonding, or mass reflow-mould underfill, but hybrid bonding is now being considered as a major player for migrating into future-gen chips. The industry experts predict that Samsung will apply the technology to its sixth-generation HBM4 chips and SK will implement it with its seventh-generation HBM4E memory.
It's getting harder and expensive to make constant improvements through traditional manufacturing, where companies have shifted their focus to chip packaging or the outer casing that holds the semiconductor as the next big area. On the other hand, some advanced chips and processors are already using this method to boost their performance.
Founded in 1958, LG Electronics has been specializing in consumer electronics, home appliances, and mobile communications, where they have been gaining significant popularity for its commitment towards innovation.
Top Stories
- A Simple Guide to Understanding Benefits of Rigid Boxes
- A Packaging Guide for Artisanal and Handmade Product Brand
- UFLEX Expands PET Recyclable Woven Polypropylene Food Packaging to Mexico
- Tetra Pak Launches India’s First Carton Packaging with Certified Recycled Polymers
- PepsiCo Reinforces pep+ Strategy with Sustainable Packaging Goals
